
没有各种各样的约束,天马星空,直接上图,然后简述思路。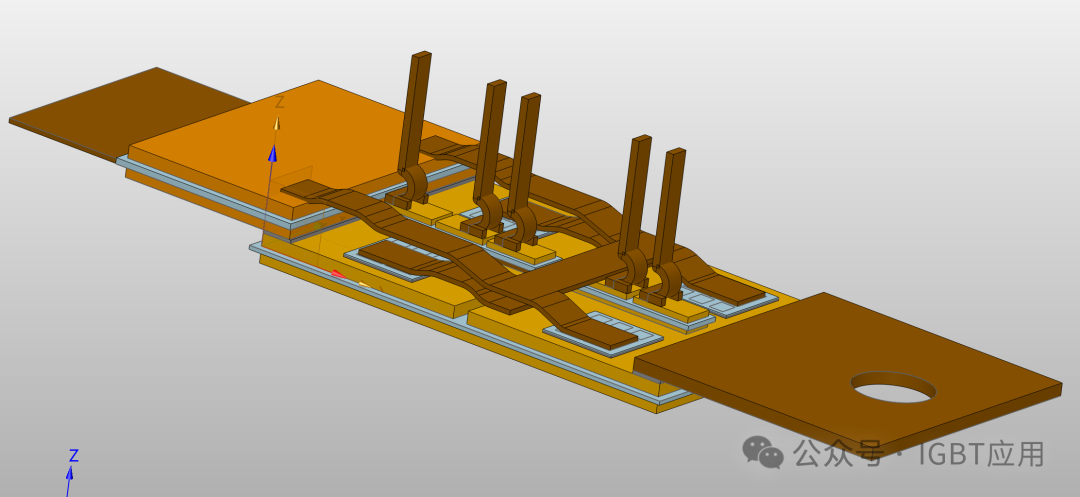
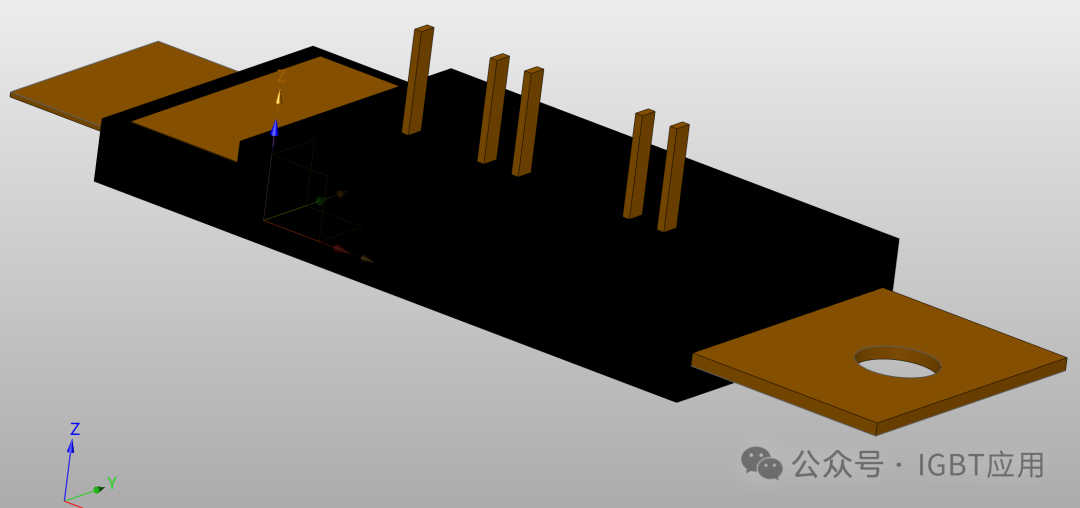
这个设计的出发点还是做叠排,把杂散电感降低。但是如果是在HPD里面做,然后芯片并排放的话效果不会太好。因此两个芯片对称放一起,并且拉开距离。模块之间并联的话也有一定距离可以降低耦合。在模块内做芯片并联是不是最优解,我觉得不一定。像HPD那样芯片距离非常近其实也是对散热做了一定的折中,,而且英飞凌的芯片对于模块设计更加友好,其他厂家的芯片未必。方案中芯片内部只有两个芯片,可以做更细致的分bin,远远比8个芯片分bin容易现实的多。模块之间的并联,其实大家在IGBT上面已经经验非常丰富了。下桥臂连接到负母排之前需要连接,这是需要的。模块内的两个芯片优化分bin,同时采用Kelvin打线。再加上较低且一直的source杂感,比较容易应对各种corner情况下的均流以及避免震荡。也可以尝试common source的打线方式。做起来比较麻烦,但是可以避免震荡的问题。DBC充当模块的正负母排,与电容连接。考虑到激光焊接的特性。DBC正端焊接或者激光或者其他方式连接一个铜排。塑封后就可以实现一上一下且保留爬电距离的正负端子。很容易与电容激光焊接。小的DBC在主DBC上,这样使主DBC上有比较好的散热特性。也可以不用小DBC,用PCB也是可以的,PCB可以更好的做电路,以及降低驱动回路杂感。而且用PCB可以给端子出线带来了更大的灵活性。亦或者直接在主DBC上做控制电路,都可以。
后焊接,也就是模块塑封后焊接到散热器上。很显然,模块越小越容易焊接。良率肯定是芯片数量越少,良率越高。也意味着成本更低。Clip不好做,可以打线,用DBB,铜线载流能力强发热低。可以较长距离打线。铝线就不好做,需要在DBC是设计回路,这样的话肯定不如Clip或者DBB的效果好,也不太好用厚铜的DBC。
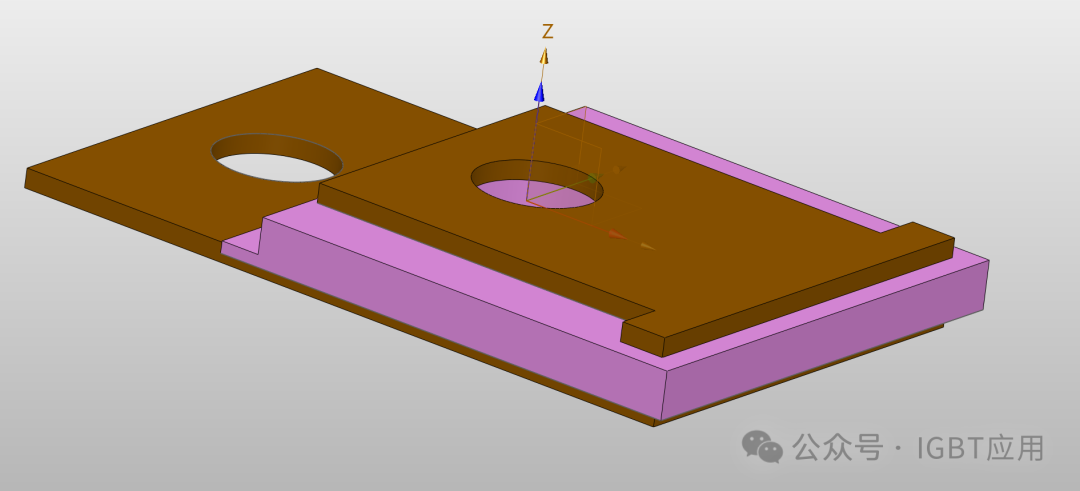

除了激光焊接,还可以弄螺丝拧的方案,如图所示。可以轻松的通过螺丝的方式实现叠层母排。这个比赛米控的方案好的是,每个母排的连接都可以实现两面接触,更可靠。只是有点费螺丝。
原创文章,转载请注明出处:http://mysic.cn/blog/article/noval_module/